Mikroskopische Verfahren

Rasterelektronenmikroskopie - SEM
Bei der Rasterelektronenmikroskopie (SEM) wird ein fein-fokussierter Elektronenstrahl (wenige nm) rasterförmig über die Oberfläche bewegt und gleichzeitig die durch Wechselwirkung mit der Oberfläche hervorgerufene Sekundärelektronenemission gemessen. Mit Hilfe der Rasterelektronenmikroskopie können hochauflösende Aufnahmen von Oberflächen mit hoher Tiefenschärfe erzeugt werden. Abhängig von der Art der detektierten Sekundärelektronen können REM-Aufnahmen mit dem üblichen Topographie- sowie mit einem zusätzlichen Materialkontrast aufgenommen werden. Letzterer liefert neben der Topographie zusätzlich Informationen über die Elementverteilung auf der Oberfläche. Die Rasterelektronenmikroskopie gehört heutzutage zu den Standardverfahren in der Materialanalytik. Sie bildet die Basis zahlreicher weiterer Verfahren, wie der Transmissionselektronenmikroskopie (STEM), der Elektronenrückstreubeugung (EBSD) oder der Energiesipersiven Röntgenanalye (EDX).
Geräte: Helios Nanolab 600, Omicron NanoSAM
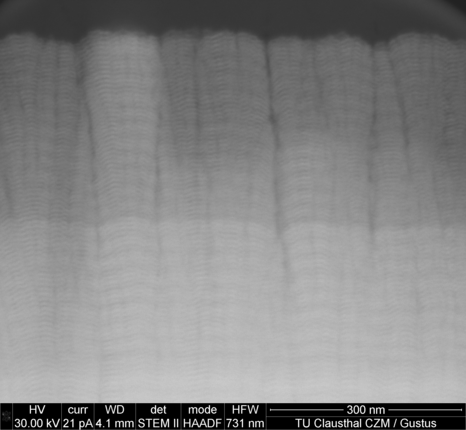
Rastertransmissionselektronenmikroskopie - STEM
Die Rastertransmissionselektronenmikroskopie (STEM) ist ein bildgebendes Verfahren mit dem die Mikrostruktur im Inneren eines Objekts abgebildet werden kann. Ähnlich wie bei der Rasterelektronenmikroskopie wird ein fein-fokussierter Elektronenstrahl Punkt für Punkt über das zu untersuchenden Obejekts gerastert, wobei in diesem Falls die durch die Probe transmittierten Elektronen detektiert und zur Bilderzeugung herangezogen werden. Mittels STEM können Proben bis zu einer Dicke von rund 200 nm gemessen werden. Hierfür müssen die Proben auf ein entsprechendes TEM-Netz präpariert werden. In Kombination mit der FIB-Technik lassen sich ebenfalls aus einer Materialoberfläche herausgeschnitte Lamellen mittels STEM analysieren.
Geräte: Helios Nanolab 600
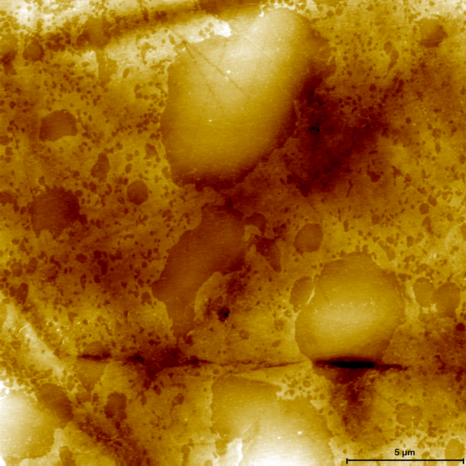
Rasterkraftmikroskopie - AFM
Mit Hilfe der Rasterkraftmikroskopie (AFM) kann die Oberflächentopographie einer Probe abgebildet und quantitativ analysiert werden. Hierfür wird ein sogenannter Cantilever an dessen Ende sich eine feine Spitze befindet über die Oberfläche bewegt und die repulsiven Kräfte zwischen den äußeren Atomen der Spitze und der Oberfläche als Regelgröße verwendet. Als Messgröße dienen entweder die Höhe der repulsiven Kraft (z-Position des Cantilevers wird konstant gehalten) oder die benötigte Nachregelung des Abstands Spitze-Oberfläche (repulsive Kraft wird konstant gehalten). Im Gegensatz zur Rasterelektronenmikroskopie liefert die Rasterkraftmikroskopie neben der 2-dimensionalen Darstellung der Topographie zusätzlich echte Höheninformationen. So eignet sich das Verfahren beispielsweise zur Bestimmung von Schichtdicken oder zur Vermessung strukturieter Oberflächen. Hierbei können z.B. auch statistische Größen wie Rauheitswerte einer Oberfläche bestimmt werden.
Geräte: Dimension DI-3100

Elektronenrückstreubeugung - EBSD
Bei der Elektronenrückstreubeugung (EBSD) handelt es sich um eine kristallographische Messmethode mit der Informationen über die Kristallstruktur an der Materialoberfläche gewonnen werden können. Die EBSD-Technik kommt für gewöhnlich in einem Rasterelektronenmikroskop zum Einsatz und basiert auf der Beugung elastisch rückgestreuter Elektronen an den Kristallgitterflächen des Festkörpers. Für die Messung wird die Probe in einem Winkel von 70° zum Primärelektronenstrahl eingespannt und mit Elektronen definierter Energie beschossen. Wird für einfallende Elektronen die Braggbedingung erfüllt, so kann es zu konstruktiver Interferenz kommen. Die Messsung des entstehenden Beugungsbildes gibt Auskunft über die Kristallsymmetrie sowie die Kristallorientierung. Mittels EBSD können darüber hinaus Informationen über Korngrenzen sowie über Spannungen in der Kristallstruktur gewonnen werden. Durch die Kopplung der Messmethode mit der Rasterelektronenmikroskopie wird eine ortsaufgelöste Analyse der beschriebenden Kristalleigenschaften ermöglicht.
Geräte: Helios Nanolab 600

Konfokale Lasermikroskopie - CLSM
Bei der Konfokalen Lasermikroskopie (CLSM) wird die Topographie der Oberfläche mittels Laserstrahlen erfasst. Hierfür wird der Laser auf die Oberfläche fokussiert und das reflektierte Licht hinter einer Lochblende gemessen. Diese Technik ermöglicht eine um ein Drittel verbesserte laterale Auflösung im Vergleich zu einem klassischen Weitfeldmikroskop. Mit dem Fokus des Lasers wird die Probe ebenenweise abgerastert, wobei ähnlich wie bei der Rasterkraftmikroskopie die Höhe eines Punktes auf der Oberfläche quantitativ erfasst werden kann. Die Konfokale Lasermikroskopieermöglicht daher die dreidimensionale topographische Abbildung einer Oberfläche.
Geräte: Keyence VK-X210

Nano-Computertomographie - Nano-CT
Mit Hilfe der Computertomographie kann die innere Struktur eines Objekts zerstörungsfrei abgebildet werden. Die Probe wird hierfür aus verschiedenen Winkeln mit Röntgenstrahlung durchstrahlt und die hierbei entstehenden Schattenbilder aufgenommen. Mittels computergestützter Auswertung werden die entstandenen Schattenbilder genutzt um die 3-dimensionale Struktur des Objekts zu rekonstruieren. Die Computertomographie kann beispielsweise genutzt werden um Poren, Einschlüsse oder Defekte im Inneren eines Materials sichtbar zu machen.
Geräte: Skyscan 2011